모바일 산업과 PCB의 관계
ㅇ 모바일 산업이 발전함에 따라 모바일 단말기에도 많은 것들이 요구되어 짐. 고속화, 경량화, 소형화, 친환경, 고집적화의 요구에 따라 PCB도 거기에 알맞은 기능이 요구되어 지고 있는 실정이며 크게 층간 연결 방법, 기판의 두께, 고집적화(미세회로화, 임베디드화), 전송 속도로 나눌 수 있음.
- 모바일용 메인기판으로 사용되는 PCB는 빌드업 공법을 사용하는데 이 방법은 도체층과 절연층을 양면에서 1층씩 형성하고 도체층을 쌓아 올리는 방법인데 이방법이 필요한 이유는 휴대폰이나 tablet PC의 크기 두께가 계속 줄어드는 것에 대응하기 위함이며 기존 제품보다 공간의 활용폭과 공간 자유도가 높음.
- 층간 연결 방법은 기존 CNC 드릴과 레이져 드릴을 이용한 방법을 적용하였음. 구조적으로 볼 때 Stack via, Staggered via을 사용하였으나, 스마트폰의 고기능화와 고속화가 이루어지면서 레이저 드릴, Paste 잉크등 여러 방법을 이용한 All Stack via로 발전, 양산되고 있음.
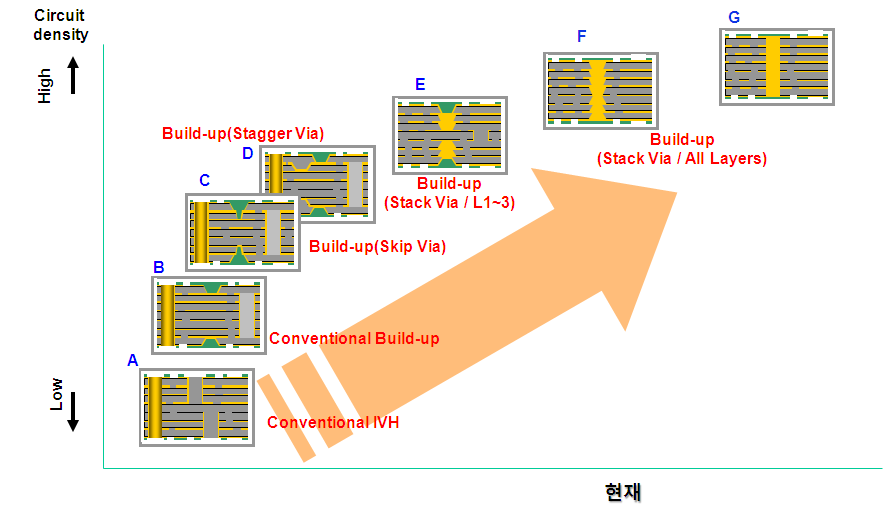
< 층간 연결 방법 Trend >
- 최근의 스마트폰에 사용되는 PCB는 3층 stack via가 주로 사용되고 있으며 스마트폰의 주 입력장치로 터치스크린이 사용되면서 기존에 키패드(Key Pad)를 사용할 때보다 HDI의 크기는 획기적으로 축소되었음.
- 특히 배터리 용량의 증가로 부피가 커지고 각종 센서 등의 장착으로 회로는 더욱 집적되면서도 공간효율성이 개선되는 방향으로 빌드업 기술이 진화되고 있는데 현재 하이 엔드급 스마트폰에는 층간 회로 연결을 위한 Via 위에 다른 Via를 추가로 연결(Stacked Via)하여 3층 이상의 층간 접속이 가능하도록 한 기술적 난이도가 높은 제품들이 적용되고 있음.

<스마트폰에 사용되는 3 stack via PCB>
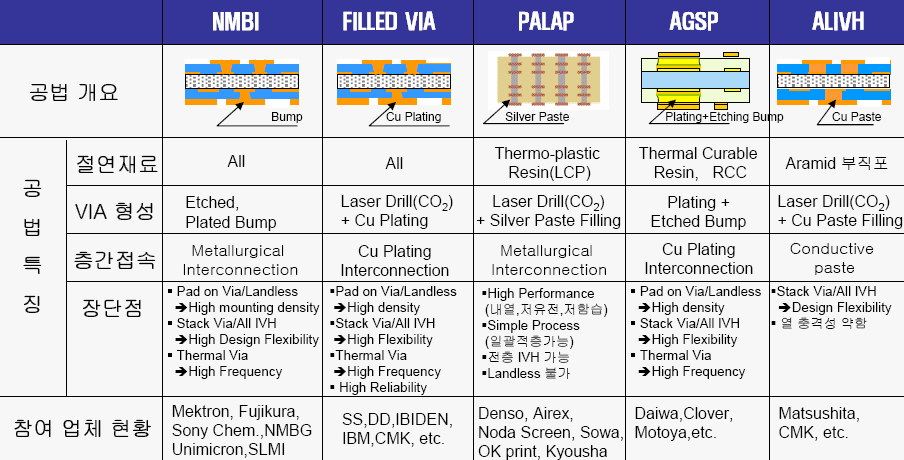
< All Stack Via 기술 비교>
ㅇ 기판의 두께는 10층 PCB기판을 기준으로 과거 0.8mm에서 최근 0.65mm까지 얇아진 상태이며, 향후 0.6~0.5mm까지 얇아질 전망.
ㅇ 고집적화를 위해 회로 폭은 50um가 현재 주류를 이루고 있으나, 향후 40um~30um까지 Fine화 될 전망이며, 그와 동시에 많은 기능적 수행을 위한 수동 칩의 내장화가 양산중이며, 능동 칩의 내장화도 활발한 개발 진행중임.
ㅇ FPCB의 경우 스마트폰 태블릿 PC에는 이전의 모바일 기기에 장착되지 않던 각종 센서와 고화소 카메라모듈, 터치스크린패널 등이 아래그림과 같이 기본적으로 장착되고 있어 기능적인 중요도가 점차 증가하고 있음.
- 이러한 각종 부품을 메인 보드에 연결하기 위해서는 굴곡성을 보유하고 회로가 형성되어 있는 신뢰도가 높은 커넥터가 필요한데 FPCB는 이러한 커넥터 역할을 담당하고 있으며 전방산업의 성장에 따라 사용량이 지속적으로 증가하고 있어 HDI, 패키지 기판과 함께 PCB 산업 내에서 성장성이 높은 제품으로 부각되고 있음.
- 기술적으로도 과거 feature phone에 비해 선폭이 25~50 ㎛ 수준으로 향상되었으며 층수도 과거 4~6층에서 8~12층의 고다층 FPCB에 대한 요구도 증가하고 있음.

< 과거 feature phone과 스마트폰에서의 FPCB비중 및 역할>
- 스마트폰 응용과 더불어 가장 큰 응용 산업중 하나인 태블릿 PC는 새로운 PCB 시장으로 크게 성장하고 있음. 태블릿 PC의 경우도 LCD모듈, 터치스크린 패널(TSP)용 모듈, 각종 이미지 센서를 비롯한 센서용 모듈, 볼륨이나 기타 용 FPCB 사용이 점차 증가하고 있음.

< Tablet PC에 사용되는 주요 FPCB>
ㅇ 전송 데이터 증가로 인한 손실 감소가 요구되고 있으며 기존 Dk 4.0이상의 에폭시 레진에서 Dk 3.5이하의 저유전율 자재 개발이 활발하게 이루어 지고 있으며, 그보다 Dk값이 낮은 LCP나 필름타입의 절연재 개발도 향후 이루어질 전망임.
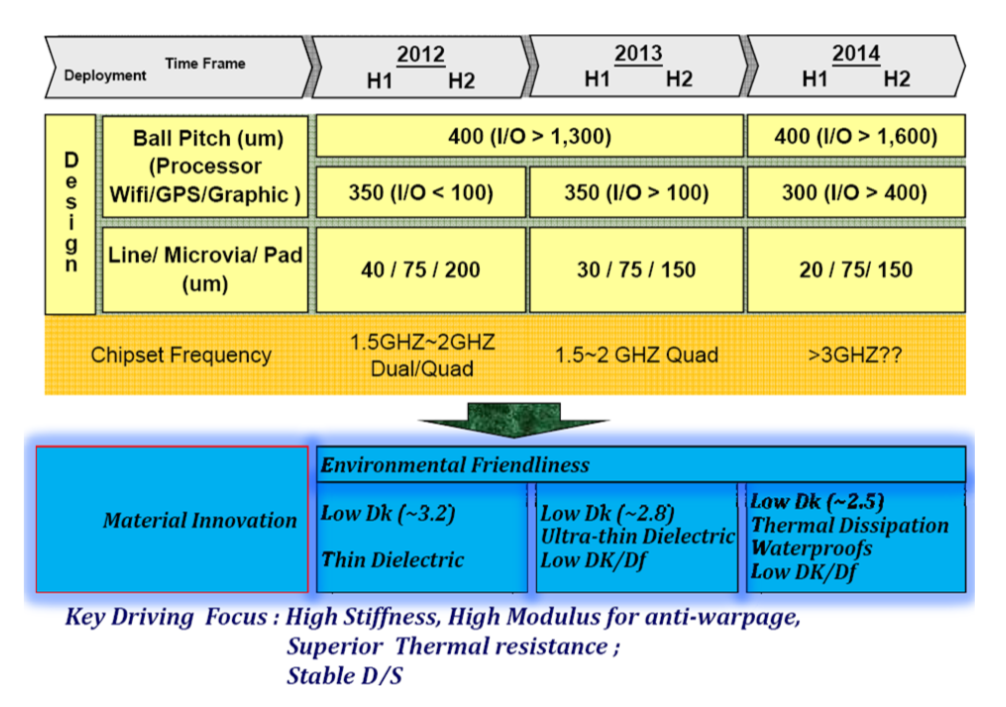
< Low Dk 재료 로드맵 >
ㅇ 휴대폰은 소형․복합화 트렌드가 업계의 화두로 부상 하면서 휴대폰에서 고화질 디스플레이 영상 구현이 가능해지면서 EMI 영향에 대한 중요성이 부각되고 있으며 전자(electron)를 이용하는 구리배선에 비해 전송속도가 월등히 빠른 광(photon) 도파로를 이용한 optical PCB의 상용화도 가까운 미래에 도래할 것으로 전망됨.
- 휴대폰은 디지털 컨버전스의 추세에 따라 각종 기능이 더해져 데이터의 처리 용량 및 속도가 증가할 것으로 예상됨.
- 특히 휴대폰의 카메라 모듈 화소수가 2008년 600만을 넘을 것으로 예상되며, 현재의 전기 Flexible PCB 기술로는 고속화 및 노이즈 문제를 해결하기 곤란함.
- 물론 휴대폰 내의 고속화 문제 해결을 위해 현재의 전기 Flexible PCB 기술은 전기의 병렬인터페이스에서 직렬인터페이스로의 변환이 이루어지고 있지만 소비전력이 증가하는 문제가 발생함.
- 현재 노키아, 삼성전자 등에서 휴대폰의 메인PCB와 카메라/디스플레이 연결구간에 광전송 기술을 구현하기 위해 연구 중에 있음.

<휴대폰내의 광연결 구조>
ㅇ 최근 Intel 에서 발표한 Light Peak 는 컴퓨터 내에서 광Fiber를 이용하여 USB 3.0 대체의 목적으로 개발하였으며, 휴대용 저장매체의 저장용량이 늘어남에 따라, 고속 전송이 용이하도록 하여 컴퓨터 외 주변기기와도 광통신을 이용하여 그 수요가 증가 할 것으로 예상됨.
ㅇ 플렉시블 부품 기술의 요구
- 최근 삼성, 노키아, 교세라, 필립스 등 글로벌 기업들의 플렉시블 단말기의 상용화에 대한 개발들이 이루어지고 있음.
- 플렉시블 단말기는 디스플레이와 뿐 아니라 플렉시블 반도체 소자 패키징기술, 플렉시블 소재, 기판, 모듈 기술, 플렉시블 배터리 기술도 병행해서 개발되어야함.
- 플렉서블 PCB 전자기술(flexible electronics)은 폴리이미드와 같이 유연하면서도 고성능의 유기 기판 상에 전자소자를 실장하거나 형성시킴으로써 전자회로를 구현하는 기술임. 잘 알려져 있는 대표적 기술로서 연성인쇄회로기판(FPCB, flexible printed circuit boards) 기술을 들 수 있음.
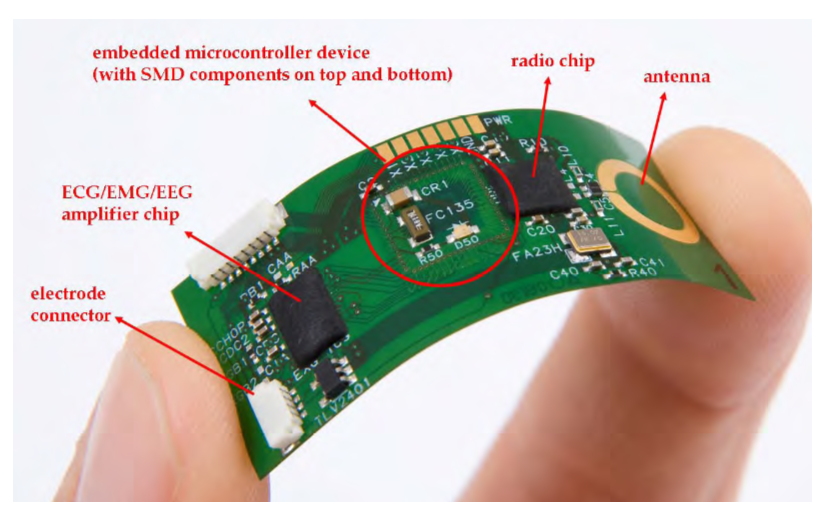
<플렉서블 무선 바이오 포텐셜 시스템.; IMEC>
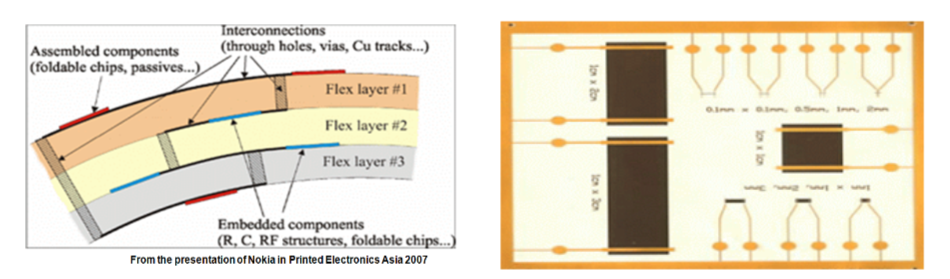
< 능동소자 IC내장형 플렉시블 기판>
ㅇ 플렉시블 단말기의 핵심 구현 기술을 위해서는 신개념의 플렉시블 기판기술이 필요함.
- Through hall, via 및 Cu 배선막을 flex 층의 표면에 수동 소자 부품과 함께 인쇄 공정으로 형성하고 능동 소자는 foldable한 수준으로 매우 얇게 제조하여 실장한 다음, 각 flex 층을 lamination 접합하여 일체화함으로써 through hall과 via를 통한 3차원 interconnection을 구현한 고집적의 다층 bendable 기판 구조가 구현 되어야함.